1. Merkmale der Sputterbeschichtung
Im Vergleich zur herkömmlichen Vakuumverdampfungsbeschichtung weist die Sputterbeschichtung die folgenden Merkmale auf:
(1) Jede Substanz kann gesputtert werden, insbesondere Elemente und Verbindungen mit hohem Schmelzpunkt und niedrigem Dampfdruck. Als Targetmaterial eignen sich Feststoffe, Metalle, Halbleiter, Isolatoren, Verbindungen, Gemische usw., Blöcke oder Granulate. Da beim Sputtern von Isoliermaterialien und Legierungen wie Oxiden nur geringe Zersetzung und Fraktionierung auftritt, lassen sich dünne Filme und Legierungsfilme mit einheitlichen, dem Targetmaterial ähnlichen Komponenten und sogar supraleitende Filme mit komplexen Zusammensetzungen herstellen. Darüber hinaus lassen sich mit dem reaktiven Sputterverfahren auch Filme aus Verbindungen herstellen, die sich vom Targetmaterial völlig unterscheiden, wie beispielsweise Oxide, Nitride, Carbide und Silicide.
(2) Gute Haftung zwischen dem gesputterten Film und dem Substrat. Da die Energie gesputterter Atome um ein bis zwei Größenordnungen höher ist als die verdampfter Atome, erzeugt die Energieumwandlung der auf dem Substrat abgeschiedenen hochenergetischen Teilchen eine höhere thermische Energie, die die Haftung der gesputterten Atome am Substrat verbessert. Ein Teil der hochenergetischen gesputterten Atome wird in unterschiedlichem Maße injiziert und bildet eine sogenannte Pseudodiffusionsschicht auf dem Substrat, in der sich die gesputterten Atome und die Atome des Substratmaterials miteinander „mischen“. Während des Beschusses mit den Sputterpartikeln wird das Substrat zudem kontinuierlich in der Plasmazone gereinigt und aktiviert. Dadurch werden schlecht haftende, abgeschiedene Atome entfernt und die Substratoberfläche gereinigt und aktiviert. Dadurch wird die Haftung der gesputterten Filmschicht am Substrat deutlich verbessert.
(3) Hohe Dichte der Sputterbeschichtung, weniger Nadellöcher und höhere Reinheit der Filmschicht, da keine Tiegelverunreinigung auftritt, die bei der Vakuumdampfabscheidung während des Sputterbeschichtungsprozesses unvermeidlich ist.
(4) Gute Kontrollierbarkeit und Reproduzierbarkeit der Schichtdicke. Da Entladestrom und Targetstrom beim Sputtern getrennt voneinander geregelt werden können, lässt sich die Schichtdicke über den Targetstrom steuern. Dadurch sind die Kontrollierbarkeit und Reproduzierbarkeit der Schichtdicke durch Mehrfachsputtern gut, und eine Schicht mit vorgegebener Dicke kann effektiv aufgebracht werden. Darüber hinaus ermöglicht das Sputtern eine gleichmäßige Schichtdicke über eine große Fläche. Bei herkömmlichen Sputterverfahren (hauptsächlich Dipolsputtern) ist die Ausrüstung jedoch kompliziert und erfordert Hochdruckgeräte. Die Schichtbildungsgeschwindigkeit beim Sputtern ist niedrig. Die Vakuumverdampfungsrate beträgt 0,1–5 nm/min, während die Sputterrate 0,01–0,5 nm/min beträgt. Der Substrattemperaturanstieg ist hoch und anfällig für Verunreinigungsgase usw. Dank der Entwicklung der HF-Sputter- und Magnetronsputtern-Technologie wurden jedoch große Fortschritte bei der schnellen Sputterabscheidung und der Reduzierung der Substrattemperatur erzielt. Darüber hinaus werden in den letzten Jahren neue Sputterbeschichtungsverfahren untersucht – basierend auf planarem Magnetronsputtern – um den Sputterluftdruck bis zum Nulldrucksputtern zu minimieren, bei dem der Druck des Ansauggases während des Sputterns Null beträgt.
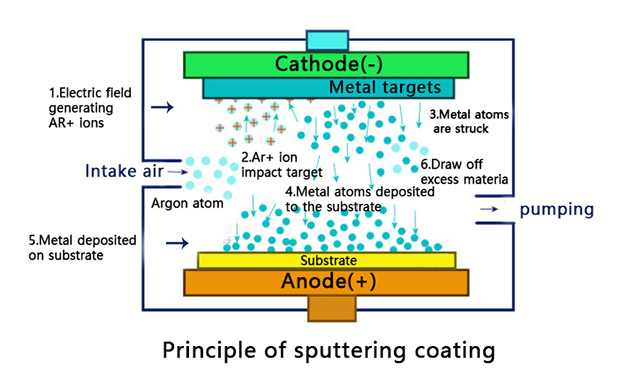
Beitragszeit: 08.11.2022

