1、შესხურების საფარის მახასიათებლები
ჩვეულებრივ ვაკუუმ-აორთქლების საფართან შედარებით, გაფრქვევის საფარს აქვს შემდეგი მახასიათებლები:
(1) ნებისმიერი ნივთიერების გაფრქვევა შესაძლებელია, განსაკუთრებით მაღალი დნობის წერტილის, დაბალი ორთქლის წნევის ელემენტებისა და ნაერთების. თუ ის მყარია, იქნება ეს ლითონი, ნახევარგამტარი, იზოლატორი, ნაერთი და ნარევი და ა.შ., იქნება ეს ბლოკი, მარცვლოვანი მასალა შეიძლება გამოყენებულ იქნას სამიზნე მასალად. ვინაიდან იზოლაციური მასალებისა და შენადნობების, როგორიცაა ოქსიდები, გაფრქვევისას დაშლა და ფრაქციონირება მცირეა, მათი გამოყენება შესაძლებელია თხელი და შენადნობის ფირების დასამზადებლად, რომლებსაც აქვთ სამიზნე მასალის მსგავსი ერთგვაროვანი კომპონენტები, და თუნდაც რთული შემადგენლობის ზეგამტარი ფირები. გარდა ამისა, რეაქტიული გაფრქვევის მეთოდი ასევე შეიძლება გამოყენებულ იქნას სამიზნე მასალისგან სრულიად განსხვავებული ნაერთების ფირების მისაღებად, როგორიცაა ოქსიდები, ნიტრიდები, კარბიდები და სილიციდები.
(2) კარგი ადჰეზია გაფრქვეულ აპკსა და სუბსტრატს შორის. რადგან გაფრქვეული ატომების ენერგია 1-2 რიგით მეტია აორთქლებული ატომების ენერგიაზე, სუბსტრატზე დალექილი მაღალი ენერგიის ნაწილაკების ენერგიის გარდაქმნა წარმოქმნის უფრო მაღალ თერმულ ენერგიას, რაც აძლიერებს გაფრქვეული ატომების ადჰეზიას სუბსტრატთან. მაღალი ენერგიის გაფრქვეული ატომების ნაწილი სხვადასხვა ხარისხით შეჰყავთ სუბსტრატზე, რაც ქმნის ე.წ. ფსევდოდიფუზიურ ფენას, სადაც გაფრქვეული ატომები და სუბსტრატის მასალის ატომები „ერევა“ ერთმანეთთან. გარდა ამისა, გაფრქვეული ნაწილაკების დაბომბვის დროს, სუბსტრატი ყოველთვის იწმინდება და აქტიურდება პლაზმის ზონაში, რომელიც აშორებს ცუდად მიმაგრებულ დალექილ ატომებს, ასუფთავებს და ააქტიურებს სუბსტრატის ზედაპირს. შედეგად, გაფრქვეული აპკის ფენის ადჰეზია სუბსტრატთან მნიშვნელოვნად უმჯობესდება.
(3) გაფრქვევით დაფარვის მაღალი სიმკვრივე, ნაკლები ნახვრეტი და ფირის ფენის უფრო მაღალი სისუფთავე, რადგან არ არსებობს ტილოვან-ორთქლის დაბინძურება, რაც გარდაუვალია გაფრქვევით დაფარვის პროცესის დროს ვაკუუმური ორთქლის დალექვისას.
(4) ფირის სისქის კარგი კონტროლირებადობა და განმეორებადობა. ვინაიდან განმუხტვის დენის და სამიზნე დენის ცალ-ცალკე კონტროლირება შესაძლებელია გაფრქვევით დაფარვის დროს, ფირის სისქის კონტროლი შესაძლებელია სამიზნე დენის კონტროლით, ამრიგად, ფირის სისქის კონტროლირებადობა და ფირის სისქის რეპროდუცირება გაფრქვევით დაფარვის მრავალჯერადი გაფრქვევით კარგია და წინასწარ განსაზღვრული სისქის ფირის ეფექტურად დაფარვა შესაძლებელია. გარდა ამისა, გაფრქვევით დაფარვით შესაძლებელია ერთგვაროვანი ფირის სისქის მიღწევა დიდ ფართობზე. თუმცა, ზოგადი გაფრქვევით დაფარვის ტექნოლოგიისთვის (ძირითადად დიპოლური გაფრქვევა), აღჭურვილობა რთულია და მოითხოვს მაღალი წნევის მოწყობილობას; გაფრქვევით დაფენის ფირის ფორმირების სიჩქარე დაბალია, ვაკუუმური აორთქლების დაფენის სიჩქარეა 0.1~5 ნმ/წთ, ხოლო გაფრქვევის სიჩქარეა 0.01~0.5 ნმ/წთ; სუბსტრატის ტემპერატურის მატება მაღალია და მგრძნობიარეა მინარევების გაზის და ა.შ. მიმართ. თუმცა, რადიოსიხშირული გაფრქვევის და მაგნეტრონული გაფრქვევის ტექნოლოგიის განვითარების წყალობით, დიდი პროგრესი იქნა მიღწეული სწრაფი გაფრქვევით დაფენის მიღწევასა და სუბსტრატის ტემპერატურის შემცირებაში. გარდა ამისა, ბოლო წლებში, მიმდინარეობს გაფრქვევით დაფარვის ახალი მეთოდების შესწავლა - ბრტყელ მაგნეტრონულ გაფრქვევაზე დაფუძნებული - რათა შეფრქვევით ჰაერის წნევა მინიმუმამდე იქნას დაყვანილი ნულოვანი წნევის გაფრქვევამდე, სადაც შეფრქვევის დროს შემშვები აირის წნევა ნულის ტოლი იქნება.
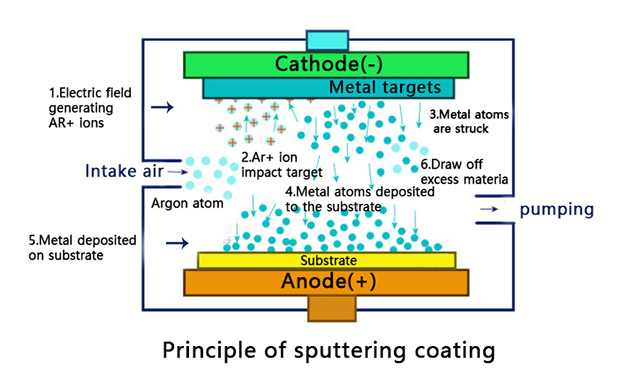
გამოქვეყნების დრო: 2022 წლის 8 ნოემბერი

