1. Funktioner hos sputterbeläggning
Jämfört med konventionell vakuumindunstningsbeläggning har sputterbeläggning följande egenskaper:
(1) Alla ämnen kan sputtras, särskilt element och föreningar med hög smältpunkt och lågt ångtryck. Så länge det är ett fast ämne, oavsett om det är en metall, halvledare, isolator, förening och blandning etc., oavsett om det är ett block, kan granulärt material användas som målmaterial. Eftersom liten nedbrytning och fraktionering sker vid sputtring av isoleringsmaterial och legeringar såsom oxider, kan de användas för att framställa tunna filmer och legeringsfilmer med enhetliga komponenter som liknar målmaterialets, och till och med supraledande filmer med komplexa sammansättningar. Dessutom kan den reaktiva sputtringsmetoden också användas för att producera filmer av föreningar som är helt olika målmaterialet, såsom oxider, nitrider, karbider och silicider.
(2) God vidhäftning mellan den sputtrade filmen och substratet. Eftersom energin hos de sputtrade atomerna är 1-2 storleksordningar högre än den hos förångade atomer, genererar energiomvandlingen av högenergipartiklar som avsätts på substratet högre termisk energi, vilket förbättrar vidhäftningen av de sputtrade atomerna till substratet. En del av de högenergisputtrade atomerna kommer att injiceras i varierande grad och bilda ett så kallat pseudodiffusionsskikt på substratet där de sputtrade atomerna och atomerna i substratmaterialet "blandas" med varandra. Dessutom, under bombardemanget av sputtrpartiklarna, rengörs och aktiveras substratet alltid i plasmazonen, vilket avlägsnar de dåligt vidhäftade utfällda atomerna, renar och aktiverar substratytan. Som ett resultat förbättras vidhäftningen av det sputtrade filmskiktet till substratet avsevärt.
(3) Hög densitet av sputterbeläggning, färre porer och högre renhet i filmskiktet eftersom det inte finns någon degelkontaminering, vilket är oundvikligt vid vakuumångavsättning under sputterbeläggningsprocessen.
(4) God styrbarhet och repeterbarhet av filmtjockleken. Eftersom urladdningsströmmen och målströmmen kan styras separat under sputterbeläggning, kan filmtjockleken styras genom att styra målströmmen, vilket gör att filmtjockleken och reproducerbarheten av filmtjockleken genom multipel sputtering av sputterbeläggningen är goda, och filmen med förutbestämd tjocklek kan beläggas effektivt. Dessutom kan sputterbeläggning erhålla en jämn filmtjocklek över ett stort område. För generell sputterbeläggningsteknik (främst dipolsputtring) är dock utrustningen komplicerad och kräver högtrycksanordning; filmbildningshastigheten vid sputterdeponering är låg, vakuumavdunstningsdeponeringshastigheten är 0,1~5 nm/min, medan sputterhastigheten är 0,01~0,5 nm/min; substrattemperaturökningen är hög och sårbar för föroreningsgas etc. På grund av utvecklingen av RF-sputtring och magnetronsputtringsteknik har dock stora framsteg gjorts när det gäller att uppnå snabb sputterdeponering och minska substrattemperaturen. Dessutom har nya metoder för sputterbeläggning undersökts på senare år – baserade på plan magnetronsputtring – för att minimera sputterlufttrycket fram till nolltryckssputtring där trycket på insugningsgasen under sputtringen kommer att vara noll.
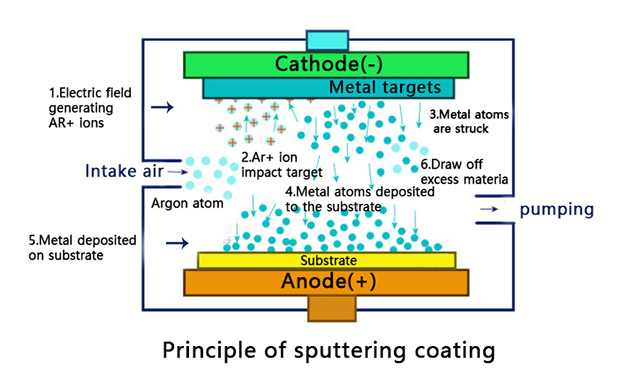
Publiceringstid: 8 november 2022

