1、ස්පටර් ආලේපනයේ විශේෂාංග
සාම්ප්රදායික රික්ත වාෂ්පීකරණ ආලේපනය හා සසඳන විට, ස්පුටරින් ආලේපනයට පහත ලක්ෂණ ඇත:
(1) ඕනෑම ද්රව්යයක්, විශේෂයෙන් ඉහළ ද්රවාංකය, අඩු වාෂ්ප පීඩන මූලද්රව්ය සහ සංයෝග ඉසිය හැක. එය ඝන ද්රව්යයක් වන තාක් කල්, එය ලෝහයක්, අර්ධ සන්නායකයක්, පරිවාරකයක්, සංයෝගයක් සහ මිශ්රණයක් යනාදිය වේවා, එය බ්ලොක් එකක් වේවා, කැටිති ද්රව්ය ඉලක්ක ද්රව්යයක් ලෙස භාවිතා කළ හැකිය. පරිවාරක ද්රව්ය සහ ඔක්සයිඩ වැනි මිශ්ර ලෝහ ඉසීමේදී සුළු වියෝජනයක් සහ ඛණ්ඩනයක් සිදුවන බැවින්, ඉලක්ක ද්රව්යයට සමාන ඒකාකාර සංරචක සහිත තුනී පටල සහ මිශ්ර ලෝහ පටල සකස් කිරීමට සහ සංකීර්ණ සංයුති සහිත සුපිරි සන්නායක පටල පවා සකස් කිරීමට ඒවා භාවිතා කළ හැකිය.´ ඊට අමතරව, ප්රතික්රියාශීලී ඉසීමේ ක්රමය ඔක්සයිඩ, නයිට්රයිඩ්, කාබයිඩ් සහ සිලිසයිඩ් වැනි ඉලක්ක ද්රව්යයෙන් සම්පූර්ණයෙන්ම වෙනස් සංයෝගවල පටල නිෂ්පාදනය කිරීමට ද භාවිතා කළ හැකිය.
(2) ඉසින ලද පටලය සහ උපස්ථරය අතර හොඳ ඇලීම. ඉසින ලද පරමාණුවල ශක්තිය වාෂ්පීකරණය වූ පරමාණුවලට වඩා විශාලත්වයෙන් 1-2 කින් වැඩි බැවින්, උපස්ථරය මත තැන්පත් කර ඇති අධි ශක්ති අංශුවල ශක්ති පරිවර්තනය ඉහළ තාප ශක්තියක් ජනනය කරයි, එමඟින් ඉසින ලද පරමාණු උපස්ථරයට ඇලවීම වැඩි දියුණු කරයි. අධි ශක්ති ඉසින ලද පරමාණුවලින් කොටසක් විවිධ මට්ටම්වලට එන්නත් කරනු ලබන අතර, උපස්ථරය මත ඊනියා ව්යාජ-විසරණ ස්ථරයක් සාදයි, එහිදී ඉසින ලද පරමාණු සහ උපස්ථර ද්රව්යයේ පරමාණු එකිනෙකා සමඟ "මිශ්ර" වේ. ඊට අමතරව, ඉසින ලද අංශු බෝම්බ හෙලීමේදී, උපස්ථරය සෑම විටම ප්ලාස්මා කලාපයේ පිරිසිදු කර සක්රිය කරනු ලැබේ, එමඟින් දුර්වල ලෙස ඇලී ඇති අවක්ෂේපිත පරමාණු ඉවත් කර, උපස්ථර මතුපිට පිරිසිදු කර සක්රිය කරයි. එහි ප්රතිඵලයක් ලෙස, ඉසින ලද පටල ස්ථරය උපස්ථරයට ඇලවීම බෙහෙවින් වැඩි දියුණු වේ.
(3) ස්පුටර් ආලේපනයේ අධික ඝනත්වය, අඩු සිදුරු සහ පටල ස්ථරයේ ඉහළ සංශුද්ධතාවය, මන්ද කබොල දූෂණයක් නොමැති බැවිනි, මෙය ස්පුටර් ආලේපන ක්රියාවලියේදී රික්ත වාෂ්ප තැන්පත් වීමේදී නොවැළැක්විය හැකිය.
(4) පටල ඝනකමේ හොඳ පාලනය කිරීමේ හැකියාව සහ පුනරාවර්තන හැකියාව. ස්පුටර් ආලේපනය අතරතුර විසර්ජන ධාරාව සහ ඉලක්ක ධාරාව වෙන වෙනම පාලනය කළ හැකි බැවින්, ඉලක්ක ධාරාව පාලනය කිරීමෙන් පටල ඝණකම පාලනය කළ හැකි බැවින්, පටල ඝණකම පාලනය කිරීමේ හැකියාව සහ ස්පුටර් ආලේපනය බහු ඉසීමෙන් පටල ඝණකම ප්රතිනිෂ්පාදනය කිරීමේ හැකියාව හොඳ වන අතර, කලින් තීරණය කළ ඝණකමෙහි පටලය ඵලදායී ලෙස ආලේප කළ හැකිය. ඊට අමතරව, ස්පුටර් ආලේපනය විශාල ප්රදේශයක් පුරා ඒකාකාර පටල ඝණකම ලබා ගත හැකිය. කෙසේ වෙතත්, සාමාන්ය ස්පුටර් ආලේපන තාක්ෂණය සඳහා (ප්රධාන වශයෙන් ඩයිපෝල් ස්පුටරින්), උපකරණ සංකීර්ණ වන අතර ඉහළ පීඩන උපාංගයක් අවශ්ය වේ; ස්පුටර් තැන්පත් වීමේ පටල සෑදීමේ වේගය අඩුය, රික්ත වාෂ්පීකරණ තැන්පත් කිරීමේ අනුපාතය 0.1~5nm/min වන අතර, ස්පුටරින් අනුපාතය 0.01~0.5nm/min වේ; උපස්ථර උෂ්ණත්වය ඉහළ යාම ඉහළ වන අතර අපිරිසිදු වායු ආදියට ගොදුරු වේ. කෙසේ වෙතත්, RF ස්පුටරින් සහ මැග්නට්රෝන් ස්පුටරින් තාක්ෂණයේ දියුණුව හේතුවෙන්, වේගවත් ස්පුටරින් තැන්පත් වීම සහ උපස්ථර උෂ්ණත්වය අඩු කිරීම සඳහා විශාල ප්රගතියක් ලබා ඇත. එපමණක් නොව, මෑත වසරවලදී, ශුන්ය පීඩන ස්පුටරින් දක්වා ඉසින වායු පීඩනය අවම කිරීම සඳහා, ප්ලැනර් මැග්නට්රෝන ස්පුටරින් මත පදනම්ව, ඉසින අතරතුර ආදාන වායුවේ පීඩනය ශුන්ය වන තෙක් ඉසින වායු පීඩනය අවම කිරීම සඳහා නව ස්පුටර් ආලේපන ක්රම විමර්ශනය කරනු ලැබේ.
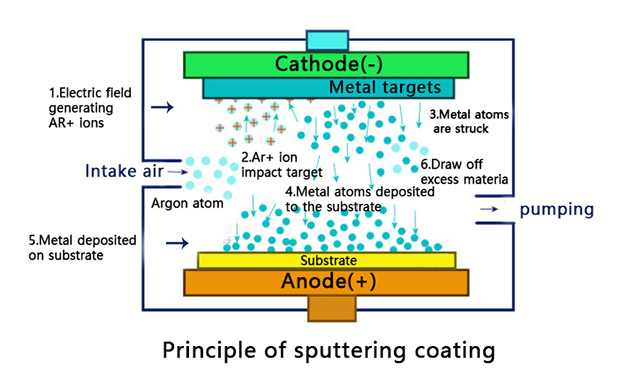
පළ කිරීමේ කාලය: නොවැම්බර්-08-2022

