1. Karatteristiċi tal-kisi bl-isputtering
Meta mqabbel mal-kisi konvenzjonali tal-evaporazzjoni bil-vakwu, il-kisi tal-isputtering għandu l-karatteristiċi li ġejjin:
(1) Kwalunkwe sustanza tista' tiġi sputterizzata, speċjalment elementi u komposti b'punt ta' tidwib għoli u pressjoni baxxa tal-fwar. Sakemm ikun solidu, kemm jekk ikun metall, semikonduttur, iżolatur, kompost u taħlita, eċċ., kemm jekk ikun blokk, materjal granulari jista' jintuża bħala materjal fil-mira. Peress li ftit li xejn iseħħu dekompożizzjonijiet u frazzjonamenti meta jiġu sputterizzati materjali iżolanti u ligi bħal ossidi, dawn jistgħu jintużaw biex jippreparaw films irqaq u films tal-liga b'komponenti uniformi simili għal dawk tal-materjal fil-mira, u anke films superkonduttivi b'kompożizzjonijiet kumplessi. Barra minn hekk, il-metodu ta' sputtering reattiv jista' jintuża wkoll biex jipproduċi films ta' komposti kompletament differenti mill-materjal fil-mira, bħal ossidi, nitridi, karburi u siliċidi.
(2) Adeżjoni tajba bejn il-film sputtered u s-sottostrat. Peress li l-enerġija tal-atomi sputtered hija 1-2 ordnijiet ta' kobor ogħla minn dik tal-atomi evaporati, il-konverżjoni tal-enerġija tal-partiċelli ta' enerġija għolja depożitati fuq is-sottostrat tiġġenera enerġija termali ogħla, li ssaħħaħ l-adeżjoni tal-atomi sputtered mas-sottostrat. Porzjon tal-atomi sputtered ta' enerġija għolja se jiġi injettat fi gradi differenti, u jifforma l-hekk imsejjaħ saff ta' pseudo-diffużjoni fuq is-sottostrat fejn l-atomi sputtered u l-atomi tal-materjal tas-sottostrat "jitħalltu" ma' xulxin. Barra minn hekk, matul il-bumbardament tal-partiċelli sputtered, is-sottostrat dejjem jitnaddaf u jiġi attivat fiż-żona tal-plażma, li tneħħi l-atomi preċipitati mwaħħlin ħażin, tippurifika u tattiva l-wiċċ tas-sottostrat. Bħala riżultat, l-adeżjoni tas-saff tal-film sputtered mas-sottostrat hija msaħħa ħafna.
(3) Densità għolja ta' kisi bl-isputtering, inqas toqob tal-pin, u purità ogħla tas-saff tal-film minħabba li m'hemm l-ebda kontaminazzjoni tal-griġjol, li hija inevitabbli fid-depożizzjoni tal-fwar bil-vakwu matul il-proċess tal-kisi bl-isputtering.
(4) Kontroll u ripetibbiltà tajbin tal-ħxuna tal-film. Peress li l-kurrent tal-ħruġ u l-kurrent fil-mira jistgħu jiġu kkontrollati separatament waqt il-kisi bl-isputtering, il-ħxuna tal-film tista' tiġi kkontrollata billi jiġi kkontrollat il-kurrent fil-mira, u b'hekk, il-kontroll tal-ħxuna tal-film u r-riproduċibbiltà tal-ħxuna tal-film permezz ta' sputtering multiplu tal-kisi bl-isputtering huma tajbin, u l-film ta' ħxuna predeterminata jista' jiġi miksi b'mod effettiv. Barra minn hekk, il-kisi bl-isputtering jista' jikseb ħxuna uniformi tal-film fuq żona kbira. Madankollu, għat-teknoloġija ġenerali tal-kisi bl-isputtering (prinċipalment sputtering dipole), it-tagħmir huwa kkumplikat u jeħtieġ apparat ta' pressjoni għolja; il-veloċità tal-formazzjoni tal-film tad-depożizzjoni bl-isputtering hija baxxa, ir-rata ta' depożizzjoni bl-evaporazzjoni bil-vakwu hija 0.1~5nm/min, filwaqt li r-rata tal-isputtering hija 0.01~0.5nm/min; iż-żieda fit-temperatura tas-sottostrat hija għolja u vulnerabbli għall-gass tal-impurità, eċċ. Madankollu, minħabba l-iżvilupp tat-teknoloġija tal-isputtering RF u tal-isputtering magnetron, sar progress kbir fil-kisba ta' depożizzjoni mgħaġġla bl-isputtering u t-tnaqqis tat-temperatura tas-sottostrat. Barra minn hekk, f'dawn l-aħħar snin, qed jiġu investigati metodi ġodda ta' kisi permezz ta' sputtering – ibbażati fuq sputtering planari tal-manjetron – biex jimminimizzaw il-pressjoni tal-arja tal-isputtering sakemm isir sputtering bi pressjoni żero fejn il-pressjoni tal-gass tad-dħul waqt l-isputtering tkun żero.
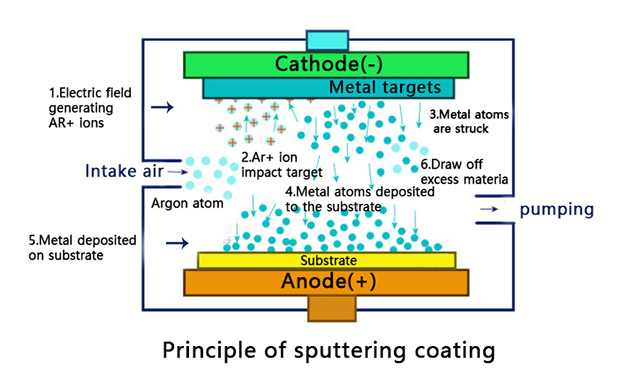
Ħin tal-posta: 08 ta' Novembru 2022

