1, ຄຸນນະສົມບັດຂອງການເຄືອບ sputter
ເມື່ອປຽບທຽບກັບການເຄືອບການລະເຫີຍສູນຍາກາດແບບທໍາມະດາ, ການເຄືອບ sputtering ມີລັກສະນະດັ່ງຕໍ່ໄປນີ້:
(1) ສານສາມາດ sputtered, ໂດຍສະເພາະຈຸດ melting ສູງ, ອົງປະກອບຄວາມກົດດັນ vapor ຕ່ໍາແລະທາດປະສົມ. ຕາບໃດທີ່ມັນເປັນຂອງແຂງ, ບໍ່ວ່າຈະເປັນໂລຫະ, semiconductor, insulator, ປະສົມແລະປະສົມ, ແລະອື່ນໆ, ບໍ່ວ່າຈະເປັນຕັນ, ວັດສະດຸ granular ສາມາດຖືກນໍາໃຊ້ເປັນວັດສະດຸເປົ້າຫມາຍ. ເນື່ອງຈາກການເນົ່າເປື່ອຍເລັກນ້ອຍແລະຊິ້ນສ່ວນເກີດຂື້ນໃນເວລາທີ່ sputtering ວັດສະດຸ insulating ແລະໂລຫະປະສົມເຊັ່ນ oxides, ເຂົາເຈົ້າສາມາດຖືກນໍາໃຊ້ເພື່ອກະກຽມຮູບເງົາບາງໆແລະຮູບເງົາໂລຫະປະສົມທີ່ມີອົງປະກອບເອກະພາບຄ້າຍຄືກັນກັບວັດຖຸເປົ້າຫມາຍດັ່ງກ່າວ, ແລະແມ້ກະທັ້ງຮູບເງົາ superconducting ທີ່ມີອົງປະກອບສະລັບສັບຊ້ອນ.
(2) ການຍຶດຕິດທີ່ດີລະຫວ່າງຮູບເງົາ sputtered ແລະ substrate ໄດ້. ເນື່ອງຈາກພະລັງງານຂອງປະລໍາມະນູ sputtered ແມ່ນ 1-2 ຄໍາສັ່ງຂອງ magnitude ສູງກວ່າຂອງປະລໍາມະນູ evaporated, ການແປງພະລັງງານຂອງອະນຸພາກພະລັງງານສູງຝາກຢູ່ໃນ substrate ສ້າງພະລັງງານຄວາມຮ້ອນທີ່ສູງຂຶ້ນ, ເຊິ່ງເສີມຂະຫຍາຍການຍຶດຫມັ້ນຂອງອະຕອມ sputtered ກັບ substrate ໄດ້. ບາງສ່ວນຂອງປະລໍາມະນູ sputtered ພະລັງງານສູງຈະຖືກສີດໃນລະດັບທີ່ແຕກຕ່າງກັນ, ປະກອບເປັນຊັ້ນ pseudo-ແຜ່ກະຈາຍຢູ່ໃນ substrate ບ່ອນທີ່ປະລໍາມະນູ sputtered ແລະປະລໍາມະນູຂອງວັດສະດຸ substrate "miscible" ເຊິ່ງກັນແລະກັນ. ນອກຈາກນັ້ນ, ໃນລະຫວ່າງການລະເບີດຂອງອະນຸພາກ sputtering, substrate ໄດ້ຖືກອະນາໄມສະເຫມີແລະ activated ໃນເຂດ plasma, ເຊິ່ງເອົາປະລໍາມະນູ precipitated ທີ່ບໍ່ດີ, ຊໍາລະແລະກະຕຸ້ນພື້ນຜິວ substrate ໄດ້. ດັ່ງນັ້ນ, ການຍຶດຕິດຂອງຊັ້ນຮູບເງົາ sputtered ກັບ substrate ແມ່ນໄດ້ຮັບການປັບປຸງຢ່າງຫຼວງຫຼາຍ.
(3) ຄວາມຫນາແຫນ້ນສູງຂອງການເຄືອບ sputter, pinholes ຫນ້ອຍ, ແລະຄວາມບໍລິສຸດທີ່ສູງຂຶ້ນຂອງຊັ້ນຮູບເງົາເນື່ອງຈາກວ່າບໍ່ມີການປົນເປື້ອນ crucible, ເປັນສິ່ງທີ່ຫຼີກລ່ຽງບໍ່ໄດ້ໃນ vacuum deposition ໃນລະຫວ່າງການຂະບວນການເຄືອບ sputter.
(4) ການຄວບຄຸມທີ່ດີແລະການເຮັດເລື້ມຄືນຂອງຄວາມຫນາຂອງຮູບເງົາ. ເນື່ອງຈາກກະແສໄຫຼແລະກະແສໄຟຟ້າສາມາດຄວບຄຸມແຍກຕ່າງຫາກໃນລະຫວ່າງການເຄືອບ sputter, ຄວາມຫນາຂອງຮູບເງົາສາມາດຄວບຄຸມໄດ້ໂດຍການຄວບຄຸມກະແສໄຟຟ້າ, ດັ່ງນັ້ນ, ການຄວບຄຸມຄວາມຫນາຂອງຟິມແລະການສືບພັນຂອງຄວາມຫນາຂອງຮູບເງົາໂດຍການເຄືອບ sputtering ຫຼາຍແມ່ນດີ, ແລະຮູບເງົາຂອງຄວາມຫນາ predetermined ສາມາດເຄືອບໄດ້ປະສິດທິພາບ. ນອກຈາກນັ້ນ, ການເຄືອບ sputter ສາມາດໄດ້ຮັບຄວາມຫນາຂອງຮູບເງົາທີ່ເປັນເອກະພາບໃນພື້ນທີ່ຂະຫນາດໃຫຍ່. ຢ່າງໃດກໍ່ຕາມ, ສໍາລັບເຕັກໂນໂລຢີການເຄືອບ sputter ທົ່ວໄປ (ສ່ວນໃຫຍ່ແມ່ນ sputtering dipole), ອຸປະກອນແມ່ນສັບສົນແລະຕ້ອງການອຸປະກອນຄວາມກົດດັນສູງ; ຄວາມໄວການສ້າງຮູບເງົາຂອງ sputtering ແມ່ນຕ່ໍາ, ອັດຕາການລະເຫີຍສູນຍາກາດແມ່ນ 0.1 ~ 5nm / ນາທີ, ໃນຂະນະທີ່ອັດຕາການ sputtering ແມ່ນ 0.01 ~ 0.5nm / ນາທີ; ການເພີ່ມຂຶ້ນຂອງອຸນຫະພູມ substrate ແມ່ນສູງແລະມີຄວາມສ່ຽງຕໍ່ອາຍແກັສ impurity, ແລະອື່ນໆ, ຢ່າງໃດກໍຕາມ, ເນື່ອງຈາກການພັດທະນາຂອງ RF sputtering ແລະເຕັກໂນໂລຊີ sputtering magnetron, ມີຄວາມຄືບຫນ້າອັນໃຫຍ່ຫຼວງໄດ້ຮັບການບັນລຸໄດ້ໄວ sputtering deposition ແລະຫຼຸດຜ່ອນອຸນຫະພູມ substrate ໄດ້. ຍິ່ງໄປກວ່ານັ້ນ, ໃນຊຸມປີມໍ່ໆມານີ້, ວິທີການເຄືອບ sputter ໃຫມ່ແມ່ນໄດ້ຖືກສືບສວນ - ໂດຍອີງໃສ່ sputtering magnetron planar - ເພື່ອຫຼຸດຜ່ອນຄວາມກົດດັນຂອງອາກາດ sputtering ຈົນກ່ວາ sputtering ຄວາມກົດດັນສູນບ່ອນທີ່ຄວາມກົດດັນຂອງອາຍແກັສໄດ້ຮັບໃນລະຫວ່າງການ sputtering ຈະເປັນສູນ.
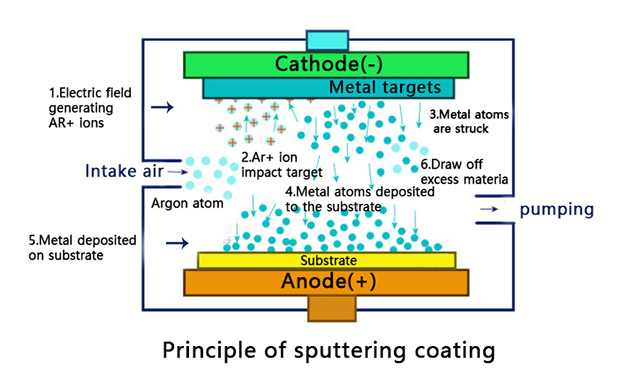
ເວລາປະກາດ: ເດືອນພະຈິກ-08-2022

