1. Proprietates depositionis per pulverizationem cathodicam
Comparata cum obductione evaporationis vacui consueta, obductione pulverisata has proprietates habet:
(1) Quaevis substantia pulverisationis percuti potest, praesertim elementa et composita cum alto puncto liquefactionis et humili pressione vaporis. Dummodo solidum sit, sive metallum, sive semiconductor, sive insulator, sive compositum et mixtura, etc., sive massa sit, materia granularis ut materia destinata adhiberi potest. Cum parva decompositio et fractionatio fiat dum materiae insulantes et mixturae metallicae, ut oxida, pulverisantur, adhiberi possunt ad pelliculas tenues et pelliculas mixturarum metallicarum cum componentibus uniformibus similibus iis materiae destinatae, et etiam pelliculas superconductrices cum compositionibus complexis praeparandas. Praeterea, methodus pulverisationis reactivae etiam adhiberi potest ad pelliculas compositorum omnino diversorum a materia destinata, ut oxida, nitrida, carbura et silicida, producendas.
(2) Bona adhaesio inter pelliculam per pulverizationem et substratum. Cum energia atomorum per pulverizationem uno vel duobus magnitudinibus ordinibus maior sit quam energia atomorum evaporatorum, conversio energiae particularum altae energiae in substrato depositarum maiorem energiam thermalem generat, quae adhaesionem atomorum per pulverizationem ad substratum auget. Pars atomorum per pulverizationem altae energiae variis gradibus iniicietur, stratum pseudo-diffusionis in substrato formans, ubi atomi per pulverizationem et atomi materiae substrati inter se "miscibiles" sunt. Praeterea, durante bombardamento particularum per pulverizationem, substratum semper purgatur et activatur in zona plasmatis, quae atomos praecipitatos male adhaerentes removet, superficiem substrati purificat et activat. Propterea, adhaesio strati pelliculae per pulverizationem ad substratum valde augetur.
(3) Alta densitas obductionis per pulverizationem cathodicam, pauciores foramina acus, et maior puritas strati pelliculae quia nulla contaminatio crucis est, quae inevitabilis est in depositione vaporis vacui durante processu obductionis per pulverizationem cathodicam.
(4) Bona moderatio et repetibilitas crassitudinis pelliculae. Cum fluxus emissarius et fluxus destinatus separatim moderari possint durante pulverizatione cathodica, crassitudo pelliculae moderari potest per moderationem fluxus destinati, ita moderatio crassitudinis pelliculae et reproducibilitas crassitudinis pelliculae bonae sunt per pulverizationem multiplicem pulverizationis cathodicae, et pellicula crassitudinis praefinitae efficaciter tegi potest. Praeterea, pulverizatio cathodica crassitudinem pelliculae uniformem per aream magnam obtinere potest. Attamen, pro technologia pulverizationis cathodicae generali (praesertim pulverizatione dipolari), apparatus complicatus est et instrumentum altae pressionis requirit; celeritas formationis pelliculae depositionis per pulverizationem cathodicam humilis est, rata depositionis evaporationis vacui est 0.1~5nm/min, dum rata pulverizationis cathodicae est 0.01~0.5nm/min; ascensus temperaturae substrati altus est et vulnerabilis gasibus impuritatum, etc. Attamen, propter progressionem technologiae pulverizationis RF et pulverizationis magnetron, magnus progressus factus est in assequenda depositione cathodica celeri et reducenda temperatura substrati. Praeterea, annis proximis, novae methodi per pulverizationem cathodicam investigantur – in pulverizatione magnetron planari fundatae – ad pressionem aeris pulverizationis minuendam usque ad pulverizationem pressionis nullae, ubi pressio gasis inducti durante pulverizatione nulla erit.
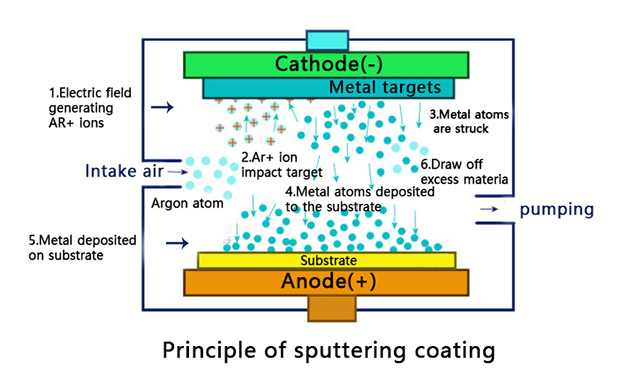
Tempus publicationis: VIII Novembris MMXXII

