1、Taybetmendiyên pêçandina sputterê
Li gorî pêçandina buharkirina valahiya kevneşopî, pêçandina sputtering xwedî taybetmendiyên jêrîn e:
(1) Her made dikare were sputterkirin, nemaze element û pêkhateyên xala helandinê ya bilind, zexta buhara nizm. Heta ku ew hişk be, çi metal be, nîvconductor be, îzoleker be, pêkhate û tevlihev be, hwd., çi blok be, materyalê granulî dikare wekî materyalê hedef were bikar anîn. Ji ber ku dema sputterkirina materyalên îzoleker û alloyên wekî oksîdan kêm hilweşîn û parçebûn çêdibe, ew dikarin ji bo amadekirina fîlmên zirav û fîlmên alloy bi pêkhateyên yekreng ên mîna yên materyalê hedef, û tewra fîlmên superconductor bi pêkhateyên tevlihev werin bikar anîn. Wekî din, rêbaza sputterkirina reaktîf dikare ji bo hilberandina fîlmên pêkhateyên bi tevahî ji materyalê hedef cuda, wekî oksîd, nîtrîd, karbîd û sîlîsîd jî were bikar anîn.
(2) Pêwendiyeke baş di navbera fîlma sputterkirî û substratê de. Ji ber ku enerjiya atomên sputterkirî 1-2 rêzên mezinahîyê ji ya atomên buharbûyî bilindtir e, veguherîna enerjiyê ya perçeyên bi enerjiya bilind ên li ser substratê hatine danîn enerjiya germî ya bilindtir çêdike, ku pêwendiya atomên sputterkirî bi substratê re zêde dike. Beşek ji atomên sputterkirî yên bi enerjiya bilind dê bi pileyên cûda werin derzîkirin, ku qatek bi navê pseudo-difûzyonê li ser substratê çêdike ku tê de atomên sputterkirî û atomên materyalê substratê bi hev re "tevlihev" dibin. Wekî din, di dema bombebarana perçeyên sputterkirî de, substrat her gav di herêma plazmayê de tê paqijkirin û çalakkirin, ku atomên barkirî yên xirab pêvekirî radike, rûyê substratê paqij dike û çalak dike. Di encamê de, pêwendiya qata fîlma sputterkirî bi substratê re pir zêde dibe.
(3) Densiya bilind a pêçandina sputterê, kêmtir qulên piçûk, û paqijiya bilindtir a qata fîlmê ji ber ku qirêjiya xaçerê tune ye, ku di dema pêvajoya pêçandina sputterê de di depoya buhara valahiyê de neçar e.
(4) Kontrolkirin û dubarekirina baş a qalindahiya fîlmê. Ji ber ku herika dakêşanê û herika hedef di dema pêçandina sputterê de dikarin ji hev cuda werin kontrol kirin, qalindahiya fîlmê dikare bi kontrolkirina herika hedef were kontrol kirin, bi vî rengî, kontrolkirina qalindahiya fîlmê û dubarekirina qalindahiya fîlmê bi pirjimarkirina sputterê baş e, û fîlma bi qalindahiya pêşwext diyarkirî dikare bi bandor were pêçandin. Wekî din, pêçandina sputterê dikare li ser deverek mezin qalindahiyek fîlmê ya yekreng bi dest bixe. Lêbelê, ji bo teknolojiya pêçandina sputterê ya giştî (bi giranî sputterkirina dîpolê), alav tevlihev e û hewceyê amûrek zexta bilind e; leza avakirina fîlmê ya danîna sputterê kêm e, rêjeya danîna buharbûna valahiyê 0.1~5nm/min e, lê rêjeya sputterkirinê 0.01~0.5nm/min e; bilindbûna germahiya substratê bilind e û ji gaza nepakiyê re xeternak e, û hwd. Lêbelê, ji ber pêşkeftina teknolojiya sputterkirina RF û sputterkirina magnetronê, di bidestxistina danîna sputterkirina bilez û kêmkirina germahiya substratê de pêşkeftinek mezin hatiye bidestxistin. Herwiha, di salên dawî de, rêbazên nû yên pêçandina sputterê têne lêkolînkirin - li ser bingeha sputterkirina magnetronê ya planar - da ku zexta hewaya sputterê heta sputterkirina bi zexta sifir kêm bikin ku tê de zexta gaza wergirtinê di dema sputterkirinê de sifir be.
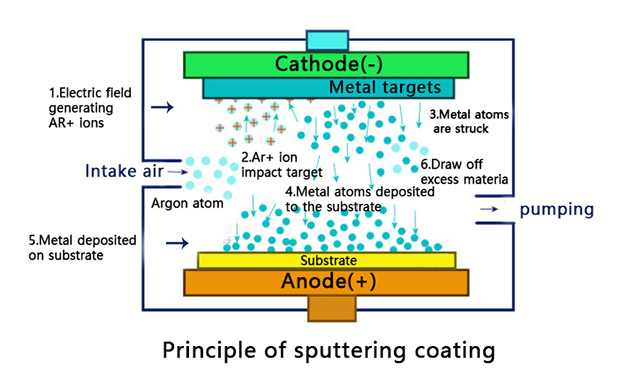
Dema weşandinê: 08-11-2022

