1、Fitur pelapisan sputter
Dibandingkan dengan pelapisan penguapan vakum konvensional, pelapisan sputtering memiliki fitur-fitur berikut:
(1) Semua zat dapat disputtering, terutama unsur dan senyawa dengan titik leleh tinggi dan tekanan uap rendah. Selama zat tersebut berupa padatan, baik berupa logam, semikonduktor, isolator, senyawa dan campuran, dll., baik berupa balok, bahan granular dapat digunakan sebagai bahan target. Karena sedikit dekomposisi dan fraksinasi yang terjadi saat sputtering bahan isolasi dan paduan seperti oksida, maka bahan tersebut dapat digunakan untuk menyiapkan film tipis dan film paduan dengan komponen seragam yang mirip dengan bahan target, dan bahkan film superkonduktor dengan komposisi kompleks.´ Selain itu, metode sputtering reaktif juga dapat digunakan untuk menghasilkan film senyawa yang sama sekali berbeda dari bahan target, seperti oksida, nitrida, karbida, dan silisida.
(2) Adhesi yang baik antara film yang disemburkan dan substrat. Karena energi atom yang disemburkan 1-2 kali lipat lebih tinggi daripada atom yang diuapkan, konversi energi partikel berenergi tinggi yang diendapkan pada substrat menghasilkan energi termal yang lebih tinggi, yang meningkatkan adhesi atom yang disemburkan ke substrat. Sebagian atom yang disemburkan berenergi tinggi akan disuntikkan ke berbagai tingkat, membentuk apa yang disebut lapisan difusi semu pada substrat tempat atom yang disemburkan dan atom bahan substrat "dapat bercampur" satu sama lain. Selain itu, selama pemboman partikel yang disemburkan, substrat selalu dibersihkan dan diaktifkan di zona plasma, yang menghilangkan atom endapan yang tidak melekat dengan baik, memurnikan dan mengaktifkan permukaan substrat. Akibatnya, adhesi lapisan film yang disemburkan ke substrat sangat ditingkatkan.
(3) Kepadatan lapisan sputter yang tinggi, lebih sedikit lubang jarum, dan kemurnian lapisan film yang lebih tinggi karena tidak ada kontaminasi wadah peleburan, yang tidak dapat dihindari dalam pengendapan uap vakum selama proses pelapisan sputter.
(4) Kontrolabilitas dan pengulangan ketebalan film yang baik. Karena arus pelepasan dan arus target dapat dikontrol secara terpisah selama pelapisan sputter, ketebalan film dapat dikontrol dengan mengendalikan arus target, dengan demikian, kontrolabilitas ketebalan film dan reproduksibilitas ketebalan film dengan beberapa sputtering pelapisan sputter baik, dan film dengan ketebalan yang telah ditentukan dapat dilapisi secara efektif. Selain itu, pelapisan sputter dapat memperoleh ketebalan film yang seragam di area yang luas. Namun, untuk teknologi pelapisan sputter umum (terutama sputtering dipol), peralatannya rumit dan memerlukan perangkat bertekanan tinggi; kecepatan pembentukan film pengendapan sputter rendah, laju pengendapan penguapan vakum adalah 0,1 ~ 5 nm / mnt, sedangkan laju sputtering adalah 0,01 ~ 0,5 nm / mnt; kenaikan suhu substrat tinggi dan rentan terhadap gas pengotor, dll. Namun, karena perkembangan teknologi sputtering RF dan sputtering magnetron, kemajuan besar telah diperoleh dalam mencapai pengendapan sputtering cepat dan mengurangi suhu substrat. Selain itu, dalam beberapa tahun terakhir, metode pelapisan sputtering baru sedang diselidiki – berdasarkan sputtering magnetron planar – untuk meminimalkan tekanan udara sputtering hingga sputtering tekanan nol di mana tekanan gas masuk selama sputtering akan menjadi nol.
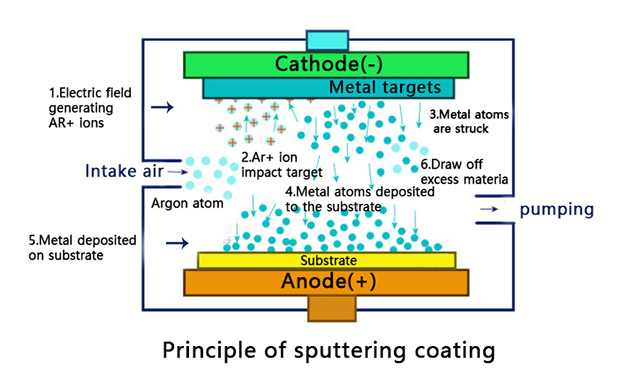
Waktu posting: 08-Nov-2022

