1、Caractéristiques du revêtement par pulvérisation cathodique
Comparé au revêtement par évaporation sous vide conventionnel, le revêtement par pulvérisation cathodique présente les caractéristiques suivantes :
(1) Toute substance peut être pulvérisée, en particulier les éléments et composés à point de fusion élevé et à faible pression de vapeur. Tant qu'il s'agit d'un solide, qu'il s'agisse d'un métal, d'un semi-conducteur, d'un isolant, d'un composé ou d'un mélange, etc., ou d'un bloc ou d'un matériau granulaire, il est possible d'utiliser comme matériau cible. La décomposition et le fractionnement étant faibles lors de la pulvérisation de matériaux isolants et d'alliages tels que les oxydes, ces derniers permettent de préparer des films minces et des films d'alliage présentant des composants uniformes similaires à ceux du matériau cible, et même des films supraconducteurs de compositions complexes. De plus, la pulvérisation réactive permet également de produire des films de composés totalement différents du matériau cible, tels que des oxydes, des nitrures, des carbures et des siliciures.
(2) Bonne adhérence entre le film pulvérisé et le substrat. L'énergie des atomes pulvérisés étant supérieure de 1 à 2 ordres de grandeur à celle des atomes évaporés, la conversion énergétique des particules à haute énergie déposées sur le substrat génère une énergie thermique plus élevée, ce qui améliore l'adhérence des atomes pulvérisés au substrat. Une partie des atomes pulvérisés à haute énergie sera injectée à des degrés divers, formant une couche dite de pseudo-diffusion sur le substrat, où les atomes pulvérisés et ceux du substrat sont miscibles entre eux. De plus, lors du bombardement des particules de pulvérisation, le substrat est constamment nettoyé et activé dans la zone plasma, ce qui élimine les atomes précipités mal adhérents, purifie et active la surface du substrat. L'adhérence du film pulvérisé au substrat est ainsi considérablement améliorée.
(3) Haute densité de revêtement par pulvérisation cathodique, moins de trous d'épingle et pureté plus élevée de la couche de film car il n'y a pas de contamination du creuset, ce qui est inévitable dans le dépôt en phase vapeur sous vide pendant le processus de revêtement par pulvérisation cathodique.
(4) Bonne contrôlabilité et répétabilité de l'épaisseur du film. Le courant de décharge et le courant cible étant contrôlables séparément lors du dépôt par pulvérisation cathodique, l'épaisseur du film peut être contrôlée par le courant cible. Ainsi, la contrôlabilité et la reproductibilité de l'épaisseur du film par pulvérisation cathodique multiple sont excellentes, permettant ainsi de déposer efficacement un film d'épaisseur prédéterminée. De plus, le dépôt par pulvérisation cathodique permet d'obtenir une épaisseur de film uniforme sur une grande surface. Cependant, pour la technologie générale de dépôt par pulvérisation cathodique (principalement la pulvérisation dipolaire), l'équipement est complexe et nécessite un dispositif haute pression. La vitesse de formation du film par dépôt par pulvérisation cathodique est faible, la vitesse de dépôt par évaporation sous vide est de 0,1 à 5 nm/min, tandis que la vitesse de pulvérisation cathodique est de 0,01 à 0,5 nm/min. L'échauffement du substrat est élevé et vulnérable aux gaz d'impuretés, etc. Cependant, grâce au développement des technologies de pulvérisation cathodique RF et magnétron, de grands progrès ont été réalisés pour obtenir un dépôt par pulvérisation cathodique rapide et réduire la température du substrat. De plus, ces dernières années, de nouvelles méthodes de revêtement par pulvérisation cathodique sont étudiées – basées sur la pulvérisation cathodique magnétron planaire – pour minimiser la pression de l’air de pulvérisation cathodique jusqu’à la pulvérisation cathodique à pression nulle où la pression du gaz d’admission pendant la pulvérisation cathodique sera nulle.
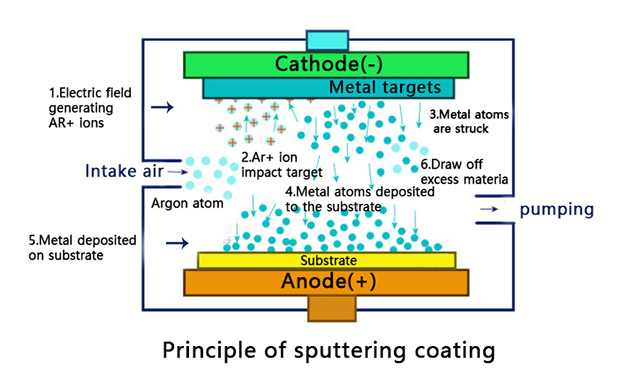
Date de publication : 08/11/2022

