۱، ویژگیهای پوششدهی اسپاترینگ
در مقایسه با پوششدهی تبخیر در خلاء مرسوم، پوششدهی کندوپاش دارای ویژگیهای زیر است:
(1) هر مادهای را میتوان کندوپاش کرد، به خصوص عناصر و ترکیبات با نقطه ذوب بالا و فشار بخار پایین. تا زمانی که جامد باشد، چه فلز، نیمهرسانا، عایق، ترکیب و مخلوط و غیره باشد، چه یک بلوک باشد، میتوان از مواد دانهای به عنوان ماده هدف استفاده کرد. از آنجایی که هنگام کندوپاش مواد عایق و آلیاژهایی مانند اکسیدها، تجزیه و تفکیک کمی رخ میدهد، میتوان از آنها برای تهیه لایههای نازک و لایههای آلیاژی با اجزای یکنواخت مشابه اجزای ماده هدف و حتی لایههای ابررسانا با ترکیبات پیچیده استفاده کرد. علاوه بر این، روش کندوپاش واکنشی همچنین میتواند برای تولید لایههایی از ترکیبات کاملاً متفاوت از ماده هدف، مانند اکسیدها، نیتریدها، کاربیدها و سیلیسیدها استفاده شود.
(2) چسبندگی خوب بین فیلم کندوپاش شده و زیرلایه. از آنجایی که انرژی اتمهای کندوپاش شده 1 تا 2 مرتبه بزرگتر از اتمهای تبخیر شده است، تبدیل انرژی ذرات پرانرژی رسوب شده روی زیرلایه، انرژی حرارتی بالاتری تولید میکند که چسبندگی اتمهای کندوپاش شده به زیرلایه را افزایش میدهد. بخشی از اتمهای کندوپاش شده با انرژی بالا به درجات مختلف تزریق میشوند و یک لایه به اصطلاح شبه نفوذی روی زیرلایه تشکیل میدهند که در آن اتمهای کندوپاش شده و اتمهای ماده زیرلایه با یکدیگر "قابل اختلاط" هستند. علاوه بر این، در طول بمباران ذرات کندوپاش شده، زیرلایه همیشه در ناحیه پلاسما تمیز و فعال میشود که اتمهای رسوب شده با چسبندگی ضعیف را از بین میبرد، سطح زیرلایه را تصفیه و فعال میکند. در نتیجه، چسبندگی لایه فیلم کندوپاش شده به زیرلایه تا حد زیادی افزایش مییابد.
(3) چگالی بالای پوششدهی اسپاترینگ، سوراخهای ریز کمتر و خلوص بالاتر لایه فیلم به دلیل عدم وجود آلودگی بوتهای، که در رسوب بخار در خلاء در طول فرآیند پوششدهی اسپاترینگ اجتنابناپذیر است.
(4) کنترلپذیری و تکرارپذیری خوب ضخامت لایه نازک. از آنجایی که جریان تخلیه و جریان هدف را میتوان در طول پوششدهی اسپاترینگ به طور جداگانه کنترل کرد، میتوان ضخامت لایه نازک را با کنترل جریان هدف کنترل کرد، بنابراین، کنترلپذیری ضخامت لایه نازک و تکرارپذیری ضخامت لایه نازک با پاشش چندگانه پوشش اسپاترینگ خوب است و لایه نازک با ضخامت از پیش تعیینشده میتواند به طور مؤثر پوشش داده شود. علاوه بر این، پوشش اسپاترینگ میتواند ضخامت لایه نازک یکنواختی را در یک منطقه بزرگ به دست آورد. با این حال، برای فناوری پوششدهی اسپاترینگ عمومی (عمدتاً اسپاترینگ دوقطبی)، تجهیزات پیچیده هستند و به دستگاه فشار بالا نیاز دارند. سرعت تشکیل لایه نازک در رسوب اسپاترینگ کم است، نرخ رسوبگذاری تبخیر خلاء 0.1 تا 5 نانومتر در دقیقه است، در حالی که نرخ پاشش 0.01 تا 0.5 نانومتر در دقیقه است. افزایش دمای زیرلایه بالا و در برابر گاز ناخالصی و غیره آسیبپذیر است. با این حال، به دلیل توسعه فناوری اسپاترینگ RF و اسپاترینگ مگنترون، پیشرفت زیادی در دستیابی به رسوبگذاری اسپاترینگ سریع و کاهش دمای زیرلایه حاصل شده است. علاوه بر این، در سالهای اخیر، روشهای جدید پوششدهی اسپاترینگ - بر اساس اسپاترینگ مگنترون صفحهای - برای به حداقل رساندن فشار هوای اسپاترینگ تا اسپاترینگ با فشار صفر که در آن فشار گاز ورودی در طول اسپاترینگ صفر خواهد بود، مورد بررسی قرار گرفتهاند.
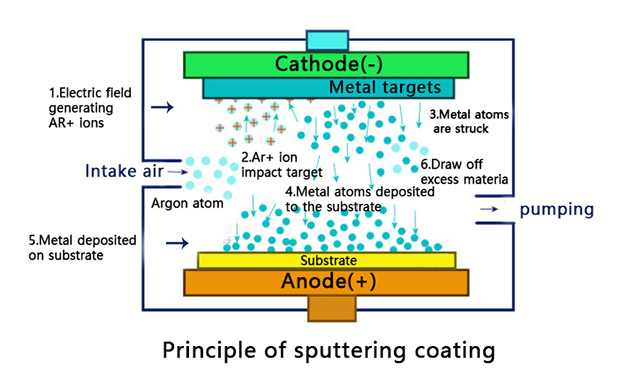
زمان ارسال: نوامبر-08-2022

