1. Ihinztadura bidezko estalduraren ezaugarriak
Ohiko hutsean lurruntze-estaldurarekin alderatuta, sputtering estaldurak ezaugarri hauek ditu:
(1) Edozein substantzia ihinztatu daiteke, batez ere urtze-puntu altuko eta lurrun-presio baxuko elementuak eta konposatuak. Solidoa bada, metala, erdieroalea, isolatzailea, konposatua eta nahasketa, etab. izan, blokea izan, material pikortsua erabil daiteke helburu-material gisa. Isolamendu-materialak eta aleazioak, hala nola oxidoak, ihinztatzean deskonposizio eta frakzionamendu gutxi gertatzen denez, helburu-materialaren antzeko osagai uniformeak dituzten film meheak eta aleazio-filmak prestatzeko erabil daitezke, eta baita konposizio konplexuak dituzten film supereroaleak ere. Horrez gain, ihinztatze erreaktiboaren metodoa helburu-materialetik guztiz desberdinak diren konposatuen filmak ekoizteko ere erabil daiteke, hala nola oxidoak, nitruroak, karburoak eta silizidoak.
(2) Ihinztadura bidezko filmaren eta substratuaren arteko atxikimendu ona. Ihinztadura bidezko atomoen energia lurrundutako atomoena baino 1-2 magnitude-ordena handiagoa denez, substratuan metatutako energia handiko partikulen energia-bihurketak energia termiko handiagoa sortzen du, eta horrek ihinztadura bidezko atomoen substratuarekiko atxikimendua hobetzen du. Energia handiko ihinztadura bidezko atomoen zati bat maila desberdinetan injektatuko da, substratuan pseudo-difusio geruza bat sortuz, non ihinztadura bidezko atomoak eta substratu materialaren atomoak elkarren artean "nahasgarriak" diren. Gainera, ihinztadura bidezko partikulen bonbardaketa bitartean, substratua beti garbitu eta aktibatzen da plasma-eremuan, eta horrek gaizki itsatsitako prezipitatutako atomoak kentzen ditu, substratuaren gainazala purifikatu eta aktibatzen du. Ondorioz, ihinztadura bidezko film geruzaren substratuarekiko atxikimendua asko hobetzen da.
(3) Ihinztadura bidezko estalduraren dentsitate handia, zulo gutxiago eta film geruzaren purutasun handiagoa, ez baitago gurutzaduraren kutsadurarik, eta hori saihestezina da hutsean lurrun bidezko deposizioan sputter estaldura prozesuan.
(4) Filmaren lodieraren kontrol eta errepikagarritasun ona. Deskarga-korrontea eta helburu-korrontea bereiz kontrola daitezkeenez sputtering-ean zehar, filmaren lodiera helburu-korrontea kontrola daiteke, horrela, filmaren lodieraren kontrolagarritasuna eta erreproduzigarritasuna sputtering-aren sputtering anizkoitzaren bidez onak dira, eta aurrez zehaztutako lodierako filma eraginkortasunez estali daiteke. Gainera, sputtering-ak filmaren lodiera uniformea lor dezake eremu handi batean. Hala ere, sputtering-aren estaldura-teknologia orokorrerako (batez ere dipolo-sputtering-a), ekipamendua konplexua da eta presio handiko gailua behar du; sputtering-aren deposizioaren filmaren eraketa-abiadura baxua da, hutsean lurruntze-deposizio-tasa 0,1~5 nm/min da, sputtering-tasa, berriz, 0,01~0,5 nm/min; substratuaren tenperaturaren igoera handia da eta ezpurutasun-gasarekiko zaurgarria da, etab. Hala ere, RF sputtering-aren eta magnetron-sputtering-aren teknologiaren garapenari esker, aurrerapen handiak lortu dira sputtering-aren deposizio azkarra lortzeko eta substratuaren tenperatura murrizteko. Gainera, azken urteotan, sputtering bidezko estaldura-metodo berriak ikertzen ari dira –magnetron planar sputtering-ean oinarrituta–, sputtering-eko aire-presioa minimizatzeko, zero presioko sputtering-era iritsi arte, non sarrerako gasaren presioa zero izango den sputtering-ean zehar.
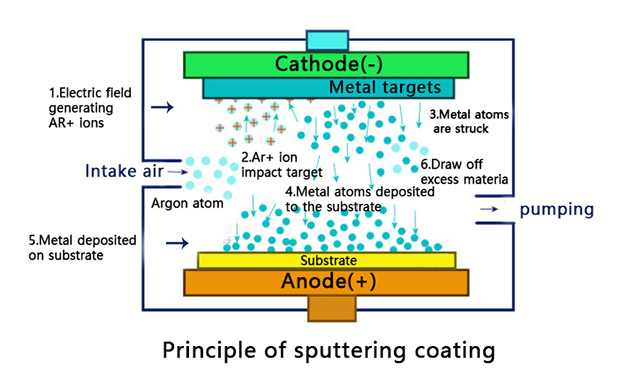
Argitaratze data: 2022ko azaroaren 8a

