1. Funktioner ved sputterbelægning
Sammenlignet med konventionel vakuumfordampningsbelægning har sputterbelægning følgende egenskaber:
(1) Ethvert stof kan forstøves, især elementer og forbindelser med højt smeltepunkt og lavt damptryk. Så længe det er et fast stof, uanset om det er et metal, en halvleder, en isolator, en forbindelse og en blanding osv., uanset om det er en blok, kan granulært materiale anvendes som målmateriale. Da der forekommer minimal nedbrydning og fraktionering ved forstøvning af isoleringsmaterialer og legeringer såsom oxider, kan de bruges til at fremstille tyndfilm og legeringsfilm med ensartede komponenter, der ligner målmaterialets, og endda superledende film med komplekse sammensætninger. Derudover kan den reaktive forstøvningsmetode også bruges til at producere film af forbindelser, der er helt forskellige fra målmaterialet, såsom oxider, nitrider, carbider og silicider.
(2) God vedhæftning mellem den sputterede film og substratet. Da energien i de sputterede atomer er 1-2 størrelsesordener højere end energien i de fordampede atomer, genererer energiomdannelsen af højenergipartikler, der afsættes på substratet, højere termisk energi, hvilket forbedrer vedhæftningen af de sputterede atomer til substratet. En del af de højenergisputterede atomer vil blive injiceret i varierende grad og danne et såkaldt pseudodiffusionslag på substratet, hvor de sputterede atomer og atomerne i substratmaterialet "blandes" med hinanden. Derudover renses og aktiveres substratet altid i plasmazonen under bombardementet af sputterpartiklerne, hvilket fjerner de dårligt vedhæftede, udfældede atomer, renser og aktiverer substratoverfladen. Som et resultat forbedres vedhæftningen af det sputterede filmlag til substratet betydeligt.
(3) Høj tæthed af sputterbelægning, færre små huller og højere renhed af filmlaget, fordi der ikke er nogen digelkontaminering, hvilket er uundgåeligt ved vakuumdampaflejring under sputterbelægningsprocessen.
(4) God styrbarhed og repeterbarhed af filmtykkelsen. Da udladningsstrømmen og målstrømmen kan styres separat under sputterbelægning, kan filmtykkelsen styres ved at styre målstrømmen. Således er styrbarheden af filmtykkelsen og reproducerbarheden af filmtykkelsen ved multipel sputtering af sputterbelægningen god, og filmen med forudbestemt tykkelse kan belægges effektivt. Derudover kan sputterbelægning opnå en ensartet filmtykkelse over et stort område. Til generel sputterbelægningsteknologi (primært dipolsputtering) er udstyret imidlertid kompliceret og kræver en højtryksanordning; filmdannelseshastigheden ved sputteraflejring er lav, vakuumfordampningsaflejringshastigheden er 0,1~5 nm/min, mens sputterhastigheden er 0,01~0,5 nm/min; substrattemperaturstigningen er høj og sårbar over for uren gas osv. På grund af udviklingen af RF-sputtering og magnetronsputteringteknologi er der imidlertid gjort store fremskridt med at opnå hurtig sputteraflejring og reducere substrattemperaturen. Derudover er der i de senere år blevet undersøgt nye sputterbelægningsmetoder – baseret på plan magnetronsputtering – for at minimere sputterlufttrykket indtil nultrykssputtering, hvor trykket af indsugningsgassen under sputtering vil være nul.
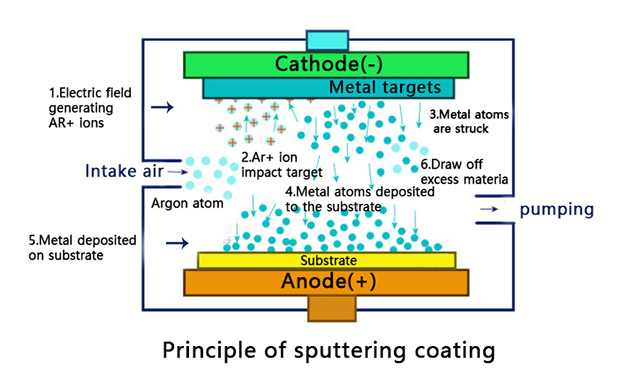
Opslagstidspunkt: 8. november 2022

