1. Caratteristiche di u rivestimentu per sputtering
In paragone cù u rivestimentu di evaporazione à vuoto cunvinziunale, u rivestimentu di sputtering hà e seguenti caratteristiche:
(1) Ogni sustanza pò esse sputterizzata, in particulare elementi è cumposti à puntu di fusione altu è bassa pressione di vapore. Finchè si tratta di un solidu, ch'ellu sia un metallu, un semiconduttore, un isolante, un cumpostu è una mistura, ecc., ch'ellu sia un bloccu, u materiale granulare pò esse adupratu cum'è materiale di destinazione. Siccomu si verifica poca decomposizione è frazziunazione quandu si sputterizzanu materiali isolanti è leghe cum'è l'ossidi, ponu esse aduprati per preparà film sottili è film di lega cù cumpunenti uniformi simili à quelli di u materiale di destinazione, è ancu film superconduttori cù cumpusizioni cumplesse. Inoltre, u metudu di sputtering reattivu pò ancu esse adupratu per pruduce film di cumposti cumpletamente diversi da u materiale di destinazione, cum'è ossidi, nitruri, carburi è siliciuri.
(2) Bona adesione trà u film sputterizatu è u substratu. Siccomu l'energia di l'atomi sputterizzati hè 1-2 ordini di magnitudine più alta di quella di l'atomi evaporati, a cunversione di l'energia di e particelle à alta energia depositate nantu à u substratu genera una energia termica più alta, chì migliora l'adesione di l'atomi sputterizzati à u substratu. Una parte di l'atomi sputterizzati à alta energia serà iniettata à diversi gradi, furmendu un cusì dettu stratu di pseudo-diffusione nantu à u substratu induve l'atomi sputterizzati è l'atomi di u materiale di u substratu sò "miscibili" trà di elli. Inoltre, durante u bombardamentu di e particelle sputterizzate, u substratu hè sempre pulitu è attivatu in a zona di plasma, chì rimuove l'atomi precipitati mal aderenti, purifica è attiva a superficia di u substratu. Di cunsiguenza, l'adesione di u stratu di film sputterizatu à u substratu hè assai migliorata.
(3) Alta densità di rivestimentu per sputtering, menu fori di spillo è una purezza più alta di u stratu di film perchè ùn ci hè micca contaminazione di u crogiolu, chì hè inevitabile in a deposizione di vapore in vuoto durante u prucessu di rivestimentu per sputtering.
(4) Bona cuntrollabilità è ripetibilità di u spessore di u film. Siccomu a corrente di scarica è a corrente di destinazione ponu esse cuntrullate separatamente durante u rivestimentu per sputtering, u spessore di u film pò esse cuntrullatu cuntrullendu a corrente di destinazione, cusì, a cuntrollabilità di u spessore di u film è a riproducibilità di u spessore di u film per sputtering multiplu di rivestimentu per sputtering sò boni, è u film di spessore predeterminatu pò esse rivestitu efficacemente. Inoltre, u rivestimentu per sputtering pò ottene un spessore di film uniforme nantu à una grande area. Tuttavia, per a tecnulugia generale di rivestimentu per sputtering (principalmente sputtering dipolo), l'equipaggiu hè cumplicatu è richiede un dispositivu à alta pressione; a velocità di furmazione di u film di deposizione per sputtering hè bassa, a velocità di deposizione per evaporazione in vuoto hè 0,1 ~ 5 nm / min, mentre chì a velocità di sputtering hè 0,01 ~ 0,5 nm / min; l'aumentu di a temperatura di u substratu hè altu è vulnerabile à u gasu di impurità, ecc. Tuttavia, per via di u sviluppu di a tecnulugia di sputtering RF è di sputtering magnetron, sò stati ottenuti grandi progressi per ottene una deposizione per sputtering rapida è riduce a temperatura di u substratu. Inoltre, in l'ultimi anni, sò stati studiati novi metudi di rivestimentu per sputtering - basati nantu à u sputtering magnetron planare - per minimizà a pressione di l'aria di sputtering finu à u sputtering à pressione zero induve a pressione di u gasu di aspirazione durante u sputtering serà zero.
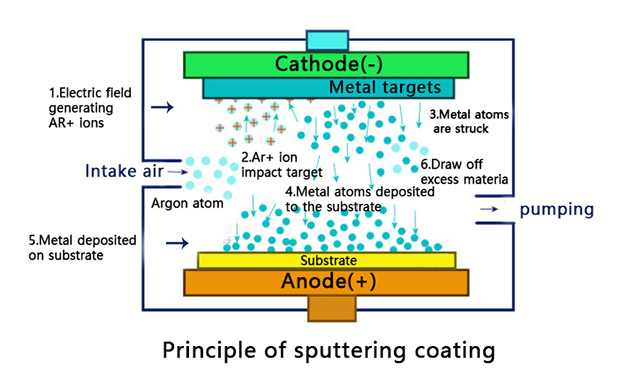
Data di publicazione: 8 di nuvembre di u 2022

