1. Kenmerke van sputterlaag
In vergelyking met konvensionele vakuumverdampingsbedekking, het sputterbedekking die volgende kenmerke:
(1) Enige stof kan gesputter word, veral elemente en verbindings met 'n hoë smeltpunt en lae dampdruk. Solank dit 'n vaste stof is, of dit nou 'n metaal, halfgeleier, isolator, verbinding en mengsel, ens. is, of dit 'n blok is, kan korrelvormige materiaal as 'n teikenmateriaal gebruik word. Aangesien min ontbinding en fraksionering plaasvind wanneer isolerende materiale en legerings soos oksiede gesputter word, kan dit gebruik word om dun films en legeringsfilms met eenvormige komponente soortgelyk aan dié van die teikenmateriaal, en selfs supergeleidende films met komplekse samestellings, voor te berei. Daarbenewens kan die reaktiewe sputtermetode ook gebruik word om films van verbindings te produseer wat heeltemal verskil van die teikenmateriaal, soos oksiede, nitrides, karbiede en silisiede.
(2) Goeie adhesie tussen die gesputterde film en die substraat. Aangesien die energie van gesputterde atome 1-2 ordes van grootte hoër is as dié van verdampte atome, genereer die energie-omskakeling van hoë-energie deeltjies wat op die substraat neergelê word, hoër termiese energie, wat die adhesie van gesputterde atome aan die substraat verbeter. 'n Gedeelte van die hoë-energie gesputterde atome sal in verskillende mate ingespuit word, wat 'n sogenaamde pseudo-diffusielaag op die substraat vorm waar die gesputterde atome en die atome van die substraatmateriaal met mekaar "meng". Daarbenewens word die substraat tydens die bombardement van die gesputterde deeltjies altyd in die plasmasone skoongemaak en geaktiveer, wat die swak aangehegte neerslagatome verwyder, die substraatoppervlak suiwer en aktiveer. Gevolglik word die adhesie van die gesputterde filmlaag aan die substraat aansienlik verbeter.
(3) Hoë digtheid van sputterbedekking, minder gaatjies en hoër suiwerheid van die filmlaag omdat daar geen kroesbesoedeling is nie, wat onvermydelik is in vakuumdampafsetting tydens die sputterbedekkingsproses.
(4) Goeie beheerbaarheid en herhaalbaarheid van filmdikte. Aangesien die ontladingsstroom en teikenstroom afsonderlik tydens sputterbedekking beheer kan word, kan die filmdikte beheer word deur die teikenstroom te beheer, dus is die beheerbaarheid van die filmdikte en die reproduceerbaarheid van die filmdikte deur veelvuldige sputtering van sputterbedekking goed, en die film van voorafbepaalde dikte kan effektief bedek word. Boonop kan sputterbedekking 'n eenvormige filmdikte oor 'n groot area verkry. Vir algemene sputterbedekkingstegnologie (hoofsaaklik dipoolsputtering) is die toerusting egter ingewikkeld en vereis dit 'n hoëdruktoestel; die filmvormingspoed van sputterafsetting is laag, die vakuumverdampingsafsettingstempo is 0.1~5nm/min, terwyl die sputtertempo 0.01~0.5nm/min is; die substraattemperatuurstyging is hoog en kwesbaar vir onsuiwerheidsgas, ens. As gevolg van die ontwikkeling van RF-sputtering en magnetron-sputteringtegnologie, is groot vordering gemaak met die bereiking van vinnige sputterafsetting en die verlaging van die substraattemperatuur. Boonop word nuwe sputterbedekkingsmetodes in onlangse jare ondersoek – gebaseer op planêre magnetronsputtering – om die sputterlugdruk te minimaliseer tot nuldruksputtering waar die druk van die inlaatgas tydens sputtering nul sal wees.
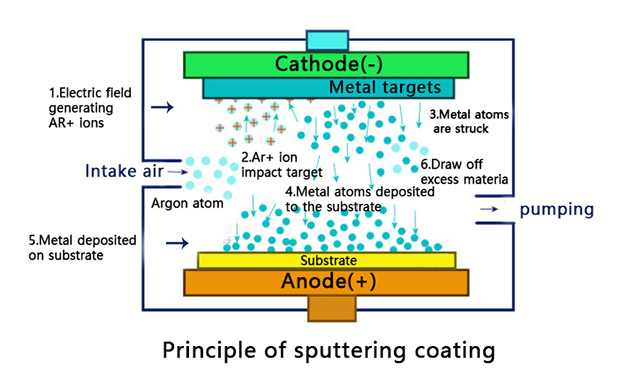
Plasingstyd: 8 November 2022

