Обычно реакции CVD основаны на высоких температурах, поэтому их называют термически возбужденным химическим осаждением из паровой фазы (TCVD). Обычно они используют неорганические прекурсоры и проводятся в реакторах с горячими и холодными стенками. Методы нагрева включают радиочастотный (РЧ) нагрев, инфракрасный нагрев, резистивный нагрев и т. д.
Химическое осаждение паров на горячих стенках
На самом деле, реактор химического осаждения из паровой фазы с горячими стенками представляет собой термостатическую печь, обычно нагреваемую резистивными элементами, для прерывистого производства. Чертеж производственного объекта химического осаждения из паровой фазы с горячими стенками для покрытия инструмента для изготовления чипов показан ниже. Это химическое осаждение из паровой фазы с горячими стенками может покрывать TiN, TiC, TiCN и другие тонкие пленки. Реактор может быть спроектирован достаточно большим, чтобы вмещать большое количество компонентов, и условия можно контролировать очень точно для осаждения. На рисунке 1 показано устройство эпитаксиального слоя для легирования кремнием производства полупроводниковых приборов. Подложка в печи размещается в вертикальном направлении, чтобы уменьшить загрязнение поверхности осаждения частицами и значительно увеличить производственную нагрузку. Реакторы с горячими стенками для производства полупроводников обычно работают при низких давлениях.
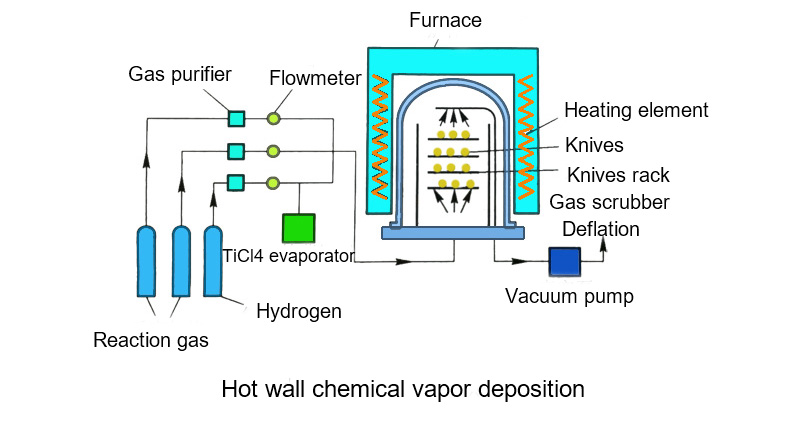
Время публикации: 08.11.2022

