Parasti CVD reakcijas balstās uz augstām temperatūrām, tāpēc tās sauc par termiski ierosinātu ķīmisko tvaiku pārklāšanu (TCVD). Tajā parasti tiek izmantoti neorganiski prekursori, un to veic karsto un auksto sienu reaktoros. Tās sildīšanas metodes ietver radiofrekvences (RF) sildīšanu, infrasarkanā starojuma sildīšanu, pretestības sildīšanu utt.
Karstās sienas ķīmiskā tvaiku nogulsnēšana
Patiesībā karstsienu ķīmiskās tvaiku uzklāšanas reaktors ir termostatiska krāsns, ko parasti silda ar rezistīviem elementiem, periodiskai ražošanai. Karstsienu ķīmiskās tvaiku uzklāšanas iekārtas rasējums mikroshēmu instrumentu pārklāšanai ir parādīts turpmāk. Šī karstsienu ķīmiskā tvaiku uzklāšanas iekārta var pārklāt TiN, TiC, TiCN un citas plānas plēves. Reaktoru var konstruēt pietiekami lielu, lai tajā varētu ievietot lielu skaitu komponentu, un apstākļus var ļoti precīzi kontrolēt uzklāšanai. 1. attēlā redzama epitaksiālā slāņa ierīce pusvadītāju ierīču ražošanas silīcija dopingam. Substrāts krāsnī ir novietots vertikālā virzienā, lai samazinātu uzklāšanas virsmas piesārņojumu ar daļiņām un ievērojami palielinātu ražošanas slodzi. Karstsienu reaktori pusvadītāju ražošanai parasti darbojas zemā spiedienā.
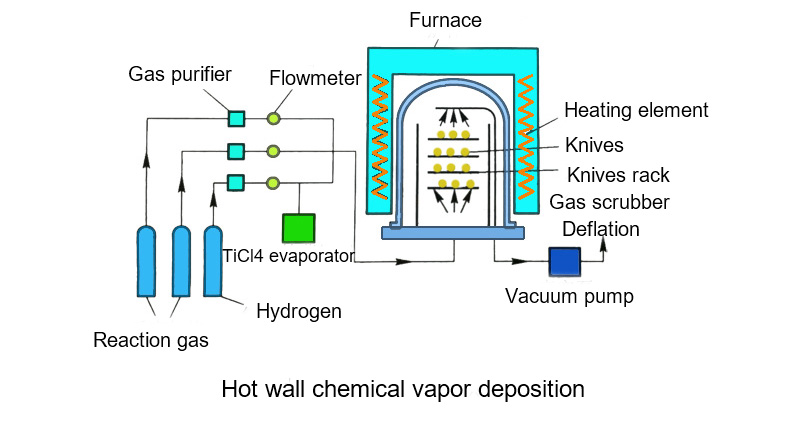
Publicēšanas laiks: 2022. gada 8. novembris

