CVD reakcije se uglavnom oslanjaju na visoke temperature, stoga se nazivaju termički pobuđeno hemijsko taloženje iz pare (TCVD). Obično koriste neorganske prekursore i izvode se u reaktorima s vrućim i hladnim zidovima. Metode zagrijavanja uključuju radiofrekventno (RF) zagrijavanje, zagrijavanje infracrvenim zračenjem, otporno zagrijavanje itd.
Hemijsko taloženje pare na vrućem zidu
Zapravo, reaktor za hemijsko taloženje iz pare s vrućim zidom je termostatska peć, obično zagrijana otpornim elementima, za povremenu proizvodnju. Crtež postrojenja za hemijsko taloženje iz pare s vrućim zidom za premazivanje alata za čipove prikazan je u nastavku. Ovo hemijsko taloženje iz pare s vrućim zidom može premazati TiN, TiC, TiCN i druge tanke filmove. Reaktor može biti dizajniran da bude dovoljno velik da primi veliki broj komponenti, a uslovi za taloženje se mogu vrlo precizno kontrolisati. Slika 1 prikazuje uređaj za epitaksijalni sloj za dopiranje silicijem u proizvodnji poluprovodničkih uređaja. Podloga u peći je postavljena u vertikalnom smjeru kako bi se smanjila kontaminacija površine za taloženje česticama i znatno povećalo proizvodno opterećenje. Reaktori s vrućim zidom za proizvodnju poluprovodnika obično rade na niskim pritiscima.
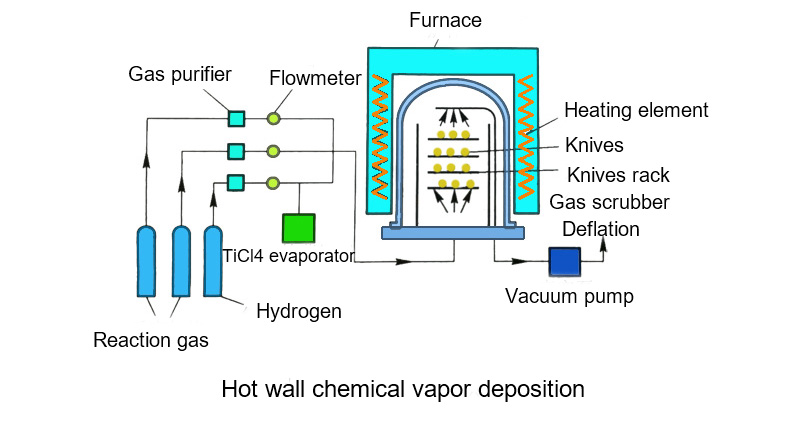
Vrijeme objave: 08.11.2022.

