රික්ත වාෂ්පීකරණ ආලේපනයේ මූලධර්මය
1, රික්ත වාෂ්පීකරණ ආලේපනයේ උපකරණ සහ භෞතික ක්රියාවලිය
රික්ත වාෂ්පීකරණ ආලේපන උපකරණ ප්රධාන වශයෙන් රික්තක කුටියක් සහ ඉවත් කිරීමේ පද්ධතියකින් සමන්විත වේ. රික්තක කුටිය තුළ, වාෂ්පීකරණ ප්රභවය (එනම් වාෂ්පීකරණ තාපකය), උපස්ථරය සහ උපස්ථර රාමුව, උපස්ථර තාපකය, පිටාර පද්ධතිය යනාදිය ඇත.
ආලේපන ද්රව්ය රික්ත කුටියේ වාෂ්පීකරණ ප්රභවයේ තබා ඇති අතර, ඉහළ රික්තක තත්වයන් යටතේ, එය වාෂ්පීකරණය සඳහා වාෂ්පීකරණ ප්රභවය මගින් රත් කරනු ලැබේ. වාෂ්ප අණු වල සාමාන්ය නිදහස් පරාසය රික්ත කුටියේ රේඛීය ප්රමාණයට වඩා විශාල වූ විට, පටල වාෂ්පයේ පරමාණු සහ අණු වාෂ්පීකරණ ප්රභවයේ මතුපිටින් ගැලවී ගිය පසු, අනෙකුත් අණු හෝ පරමාණු ගැටීමෙන් කලාතුරකින් බාධා ඇති වන අතර, ආලේප කළ යුතු උපස්ථරයේ මතුපිටට කෙලින්ම ළඟා වේ. උපස්ථරයේ අඩු උෂ්ණත්වය හේතුවෙන්, පටල වාෂ්ප අංශු ඒ මත ඝනීභවනය වී පටලයක් සාදයි.
වාෂ්පීකරණ අණු සහ උපස්ථරයේ ඇලවීම වැඩි දියුණු කිරීම සඳහා, උපස්ථරය නිසි ලෙස රත් කිරීමෙන් හෝ අයන පිරිසිදු කිරීමෙන් සක්රිය කළ හැකිය. රික්ත වාෂ්පීකරණ ආලේපනය ද්රව්ය වාෂ්පීකරණය, ප්රවාහනය සිට පටලයකට තැන්පත් වීම දක්වා පහත භෞතික ක්රියාවලීන් හරහා ගමන් කරයි.
(1) වෙනත් ආකාරයේ ශක්ති ආකාර තාප ශක්තිය බවට පරිවර්තනය කිරීම සඳහා විවිධ ක්රම භාවිතා කරමින්, පටල ද්රව්යය යම් ශක්තියක් (0.1 සිට 0.3 eV දක්වා) සහිත වායුමය අංශු (පරමාණු, අණු හෝ පරමාණුක පොකුරු) බවට වාෂ්ප වීමට හෝ උත්කෘෂ්ට කිරීමට රත් කරනු ලැබේ.
(2) වායු අංශු පටලයේ මතුපිටින් ඉවත්ව උපස්ථරයේ මතුපිටට නිශ්චිත චලිත වේගයකින්, මූලික වශයෙන් ගැටීමකින් තොරව, සරල රේඛාවකින් ප්රවාහනය කෙරේ.
(3) උපස්ථරයේ මතුපිටට ළඟා වන වායුමය අංශු ඒකාබද්ධ වී න්යෂ්ටික වී, පසුව ඝන-අදියර පටලයක් බවට වර්ධනය වේ.
(4) පටලය සෑදෙන පරමාණු ප්රතිසංවිධානය හෝ රසායනික බන්ධනය.
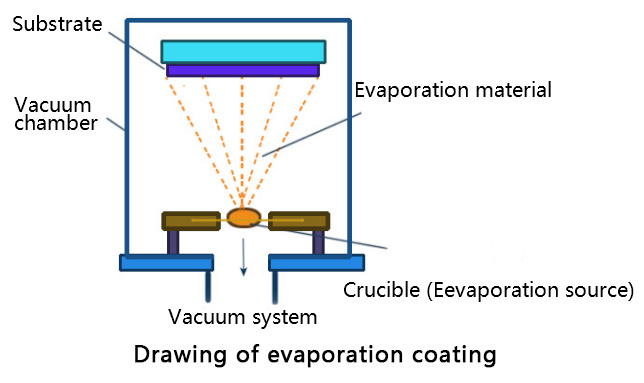
2, වාෂ්පීකරණ උණුසුම
(1) ප්රතිරෝධක තාපන වාෂ්පීකරණය
ප්රතිරෝධක තාපන වාෂ්පීකරණය යනු සරලම සහ බහුලව භාවිතා වන තාපන ක්රමය වන අතර එය සාමාන්යයෙන් 1500℃ ට අඩු ද්රවාංකයක් සහිත ආලේපන ද්රව්ය සඳහා අදාළ වේ, වයර් හෝ පත්ර හැඩයේ ඉහළ ද්රවාංක ලෝහ (W, Mo, Ti, Ta, බෝරෝන් නයිට්රයිඩ්, ආදිය) සාමාන්යයෙන් සුදුසු වාෂ්පීකරණ ප්රභවයක් බවට පත් කර, වාෂ්පීකරණ ද්රව්ය වලින් පටවා, විද්යුත් ධාරාවේ ජූල් තාපය හරහා ආලේපන ද්රව්ය උණු කිරීමට, වාෂ්ප කිරීමට හෝ උත්කෘෂ්ට කිරීමට, වාෂ්පීකරණ ප්රභවයේ හැඩයට ප්රධාන වශයෙන් බහු-නූල් සර්පිලාකාර, U-හැඩැති, සයින් තරංගය, තුනී තහඩුව, බෝට්ටුව, කේතු කූඩය යනාදිය ඇතුළත් වේ. ඒ සමඟම, ක්රමයට වාෂ්පීකරණ ප්රභව ද්රව්යයට ඉහළ ද්රවාංකයක්, අඩු සන්තෘප්ත වාෂ්ප පීඩනය, ස්ථාවර රසායනික ගුණාංග, ඉහළ උෂ්ණත්වයේ දී ආලේපන ද්රව්ය සමඟ රසායනික ප්රතික්රියාවක් නොමැති වීම, හොඳ තාප ප්රතිරෝධයක්, බල ඝනත්වයේ කුඩා වෙනසක් යනාදිය අවශ්ය වේ. එය වාෂ්පීකරණ ප්රභවය හරහා ඉහළ ධාරාවක් භාවිතා කරයි, එය සෘජු උණුසුම මගින් පටල ද්රව්ය රත් කර වාෂ්ප කරයි, නැතහොත් පටල ද්රව්ය ග්රැෆයිට් සහ ඇතැම් ඉහළ උෂ්ණත්ව ප්රතිරෝධී ලෝහ ඔක්සයිඩ් (A202, B0 වැනි) සහ වක්ර උණුසුම සඳහා වෙනත් ද්රව්ය වලින් සාදන ලද කබොලට දමයි. වාෂ්ප වී යයි.
ප්රතිරෝධක තාපන වාෂ්පීකරණ ආලේපනයට සීමාවන් ඇත: පරාවර්තක ලෝහවලට අඩු වාෂ්ප පීඩනයක් ඇති අතර එය තුනී පටලයක් සෑදීමට අපහසුය; සමහර මූලද්රව්ය තාපන වයරය සමඟ මිශ්ර ලෝහයක් සෑදීම පහසුය; මිශ්ර ලෝහ පටලයේ ඒකාකාර සංයුතියක් ලබා ගැනීම පහසු නැත. ප්රතිරෝධක තාපන වාෂ්පීකරණ ක්රමයේ සරල ව්යුහය, අඩු මිල සහ පහසු ක්රියාකාරිත්වය නිසා, එය වාෂ්පීකරණ ක්රමයේ ඉතා සුලභ යෙදුමකි.
(2) ඉලෙක්ට්රෝන කදම්භ තාපන වාෂ්පීකරණය
ඉලෙක්ට්රෝන කදම්භ වාෂ්පීකරණය යනු ආලේපන ද්රව්යය ජල සිසිලන තඹ කබොලක තබා අධි ශක්ති ඝනත්ව ඉලෙක්ට්රෝන කදම්භයකින් බෝම්බ හෙලීමෙන් වාෂ්ප කිරීමේ ක්රමයකි. වාෂ්පීකරණ ප්රභවය ඉලෙක්ට්රෝන විමෝචන ප්රභවයක්, ඉලෙක්ට්රෝන ත්වරණ බල ප්රභවයක්, කබොලක් (සාමාන්යයෙන් තඹ කබොලක්), චුම්භක ක්ෂේත්ර දඟරයක් සහ සිසිලන ජල කට්ටලයකින් සමන්විත වේ. මෙම උපකරණය තුළ, රත් වූ ද්රව්යය ජල සිසිලන කබොලක තබා ඇති අතර, ඉලෙක්ට්රෝන කදම්භය ද්රව්යයේ ඉතා කුඩා කොටසකට පමණක් බෝම්බ හෙලන අතර, ඉතිරි ද්රව්ය බොහොමයක් කබොලක සිසිලන බලපෑම යටතේ ඉතා අඩු උෂ්ණත්වයක පවතින අතර, එය කබොලක බෝම්බ හෙලන ලද කොටස ලෙස සැලකිය හැකිය. මේ අනුව, වාෂ්පීකරණය සඳහා ඉලෙක්ට්රෝන කදම්භ රත් කිරීමේ ක්රමය මඟින් ආලේපන ද්රව්ය සහ වාෂ්පීකරණ ප්රභව ද්රව්ය අතර දූෂණය වළක්වා ගත හැකිය.
ඉලෙක්ට්රෝන කදම්භ වාෂ්පීකරණ ප්රභවයේ ව්යුහය වර්ග තුනකට බෙදිය හැකිය: සෘජු තුවක්කු (බෝල්ස් තුවක්කු), වළලු තුවක්කු (විද්යුත් වශයෙන් අපගමනය කරන ලද) සහ ඊ-තුවක්කු (චුම්භක වශයෙන් අපගමනය කරන ලද). එක් හෝ වැඩි කබොල වාෂ්පීකරණ පහසුකමක තැබිය හැකි අතර, එමඟින් එකවර හෝ වෙන වෙනම විවිධ ද්රව්ය රාශියක් වාෂ්ප වී තැන්පත් කළ හැකිය.
ඉලෙක්ට්රෝන කදම්භ වාෂ්පීකරණ ප්රභවයන්ට පහත වාසි ඇත.
① ඉලෙක්ට්රෝන කදම්භ බෝම්බ හෙලීමේ වාෂ්පීකරණ ප්රභවයේ ඉහළ කදම්භ ඝනත්වය ප්රතිරෝධක තාපන ප්රභවයට වඩා බෙහෙවින් වැඩි ශක්ති ඝනත්වයක් ලබා ගත හැකි අතර එමඟින් W, Mo, Al2O3 වැනි ඉහළ ද්රවාංක ද්රව්ය වාෂ්ප කළ හැකිය.
②ආලේපන ද්රව්යය ජල සිසිලන තඹ කබොලක තබා ඇති අතර එමඟින් වාෂ්පීකරණ ප්රභව ද්රව්ය වාෂ්පීකරණය වීම සහ ඒවා අතර ප්රතික්රියාව වළක්වා ගත හැකිය.
③ආලේපන ද්රව්යයේ මතුපිටට තාපය කෙලින්ම එකතු කළ හැකි අතර, එමඟින් තාප කාර්යක්ෂමතාව ඉහළ මට්ටමක පවතින අතර තාප සන්නායකතාවය සහ තාප විකිරණය අඩු වේ.
ඉලෙක්ට්රෝන කදම්භ තාපන වාෂ්පීකරණ ක්රමයේ අවාසිය නම් ඉලෙක්ට්රෝන තුවක්කුවෙන් ලැබෙන ප්රාථමික ඉලෙක්ට්රෝන සහ ආලේපන ද්රව්යයේ මතුපිටින් ලැබෙන ද්විතියික ඉලෙක්ට්රෝන වාෂ්පීකරණ පරමාණු සහ අවශේෂ වායු අණු අයනීකරණය කිරීමයි, එය සමහර විට පටලයේ ගුණාත්මක භාවයට බලපායි.
(3) ඉහළ සංඛ්යාත ප්රේරණ තාපන වාෂ්පීකරණය
අධි-සංඛ්යාත ප්රේරක තාපන වාෂ්පීකරණය යනු අධි-සංඛ්යාත සර්පිලාකාර දඟරයේ මධ්යයේ ආලේපන ද්රව්ය සහිත කබොල තැබීමයි, එවිට ආලේපන ද්රව්යය අධි-සංඛ්යාත විද්යුත් චුම්භක ක්ෂේත්රයේ ප්රේරණය යටතේ ශක්තිමත් සුළි ධාරාවක් සහ හිස්ටෙරසිස් ආචරණයක් ජනනය කරයි, එමඟින් පටල ස්ථරය වාෂ්ප වී වාෂ්ප වන තෙක් රත් වේ. වාෂ්පීකරණ ප්රභවය සාමාන්යයෙන් ජල සිසිලන අධි-සංඛ්යාත දඟරයකින් සහ ග්රැෆයිට් හෝ සෙරමික් (මැග්නීසියම් ඔක්සයිඩ්, ඇලුමිනියම් ඔක්සයිඩ්, බෝරෝන් ඔක්සයිඩ්, ආදිය) කබොලකින් සමන්විත වේ. ඉහළ සංඛ්යාත බල සැපයුම දස දහස සිට ලක්ෂ ගණනක් Hz සංඛ්යාතයක් භාවිතා කරයි, ආදාන බලය කිලෝවොට් කිහිපයක් සිට සිය ගණනක් වේ, පටල ද්රව්යයේ පරිමාව කුඩා වන තරමට ප්රේරක සංඛ්යාතය වැඩි වේ. ප්රේරක දඟර සංඛ්යාතය සාමාන්යයෙන් ජල සිසිලන තඹ නළයකින් සාදා ඇත.
අධි-සංඛ්යාත ප්රේරක තාපන වාෂ්පීකරණ ක්රමයේ අවාසිය නම් ආදාන බලය සියුම් ලෙස සකස් කිරීම පහසු නොවීමයි, එයට පහත වාසි ඇත.
①ඉහළ වාෂ්පීකරණ අනුපාතය
②වාෂ්පීකරණ ප්රභවයේ උෂ්ණත්වය ඒකාකාරී සහ ස්ථායී වේ, එබැවින් ආලේපන බිංදු ඉසින සංසිද්ධිය නිපදවීම පහසු නොවන අතර, තැන්පත් වූ පටලයේ සිදුරු ඇතිවීමේ සංසිද්ධිය ද වළක්වා ගත හැකිය.
③ වාෂ්පීකරණ ප්රභවය එක් වරක් පටවනු ලබන අතර, උෂ්ණත්වය පාලනය කිරීමට සාපේක්ෂව පහසු සහ සරල ය.
පළ කිරීමේ කාලය: ඔක්තෝබර්-28-2022

